报告主题:碳化硅外延,“初学者”该了解哪些?
报告主题:碳化硅外延,“初学者”该了解哪些?
为什么碳化硅在电力电子领域备受关注?
SiC供应链概览
SiC外延--生长的基本原理
碳化硅外延设备
外延的表征技术和要求
总结
如需领取本文报告可关注
公众号后台回复关键词“2022”,加主编领取
报告详细内容
# 由于Si与C双原子层堆积序列的差异会导致不同的晶体结构,SiC有着超过200种(目前已知)同质多型族
最被人熟知的便是立方密排的3C-SiC和六方密排的2H-SiC、4H-SiC、6H-SiC(碳化硅具有优良的物理和化学性能)
最常用的多型是:
4H-SiC——功率集成电路应用
6H-SiC——射频应用
在不同的晶面上生长不同的晶锭多型体:
4H-SiC——在碳 (C) 面晶种上生长
6H-SiC——在硅 (Si) 面晶种上生长
与硅相比,SiC的多型性使SiC的外延生长和衬底制备更加复杂。

# 4H-SiC是功率器件的最佳选择
(6H-SiC的电子迁移率是各向异性的)
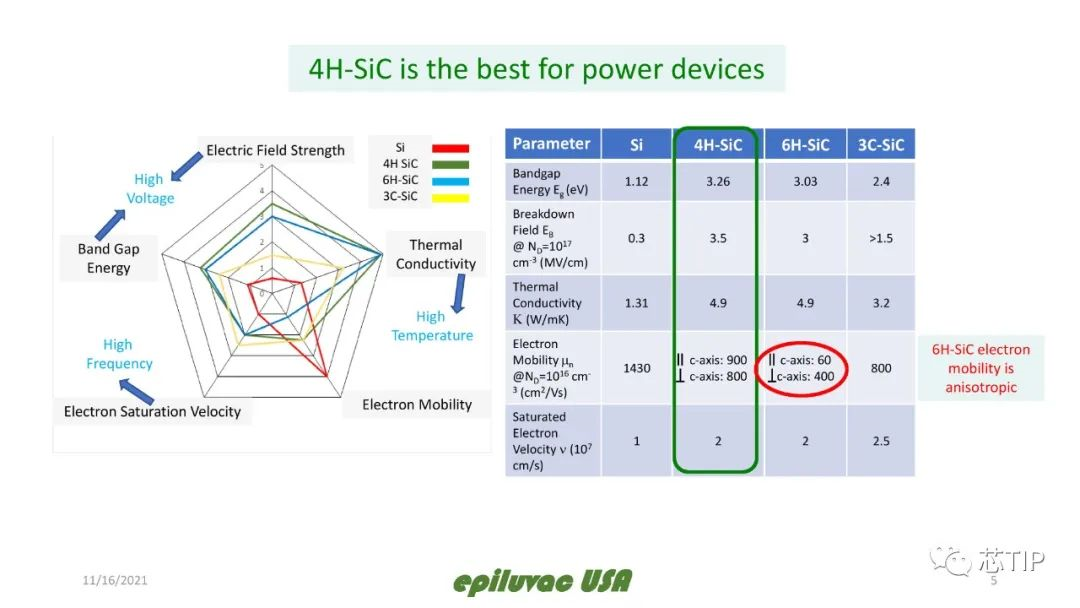
# SiC 相对于 Si 器件的优势
• SiC 的宽带隙允许更薄的外延层来阻挡给定的电压
• 较薄的漂移层降低了整体器件电阻
• 更高的电子饱和速度允许更高频率的运行
• SiC 的高导热性允许器件在 > 200C 的高温下运行

# 碳化硅供应链概览

# SiC外延生长:常见元素
衬底:
•用于电力电子的4H多型
•当前晶圆直径150 mm和200 mm
•定向4°离轴
•双面抛光
•在晶片的硅面上生长的外延
• 需要对硅表面进行仔细的化学机械抛光 (cmp) 以减少缺陷
生长参数:
•温度 ~ 1650 oC
•压力 ~ 50-100 mbar
•硅源
•碳源
•掺杂气体
•C/Si 比率——用于掺杂控制
•涂层石墨
外延片表征:
•厚度 - 目标和均匀度
•掺杂 - 目标和均匀度
•缺陷(表面缺陷、位错缺陷)
•晶圆形状(弓形等)
...
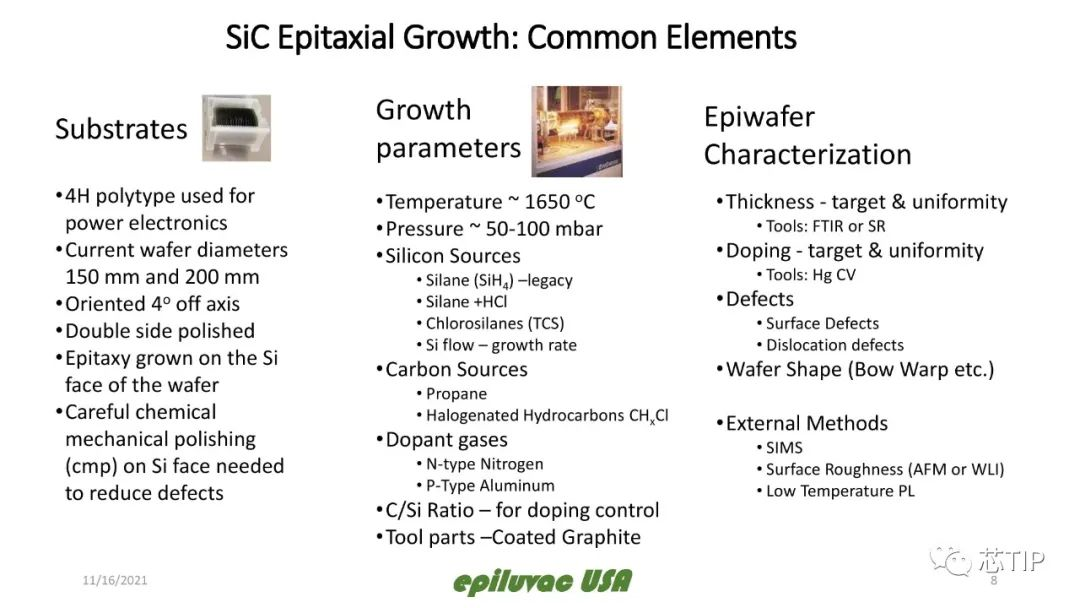
# SiC 外延生长的通用工艺示意图(温度与时间)
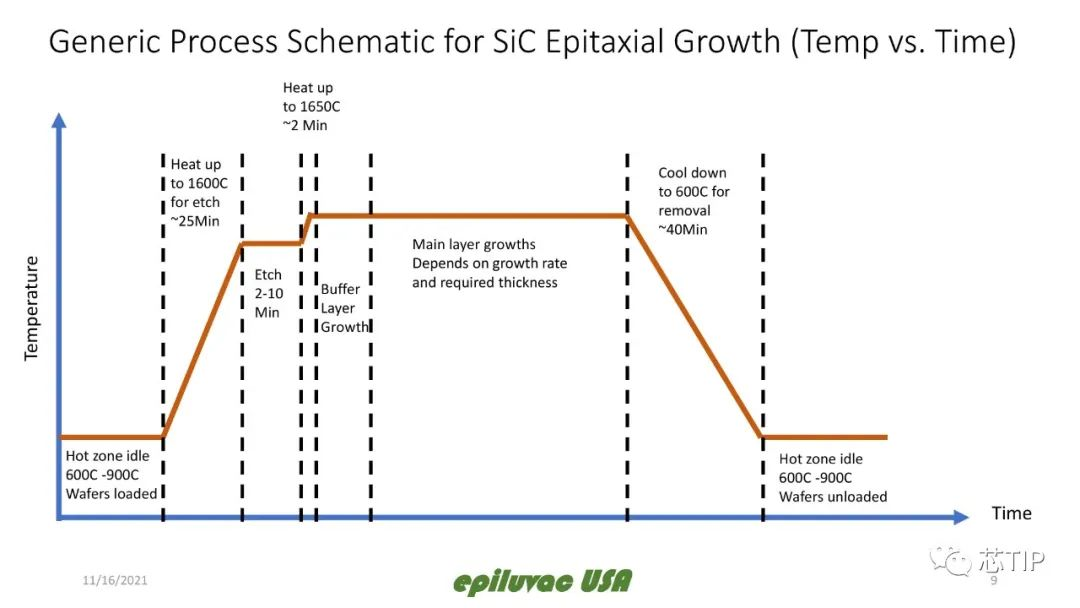
# SiC外延生长工艺:台阶流生长
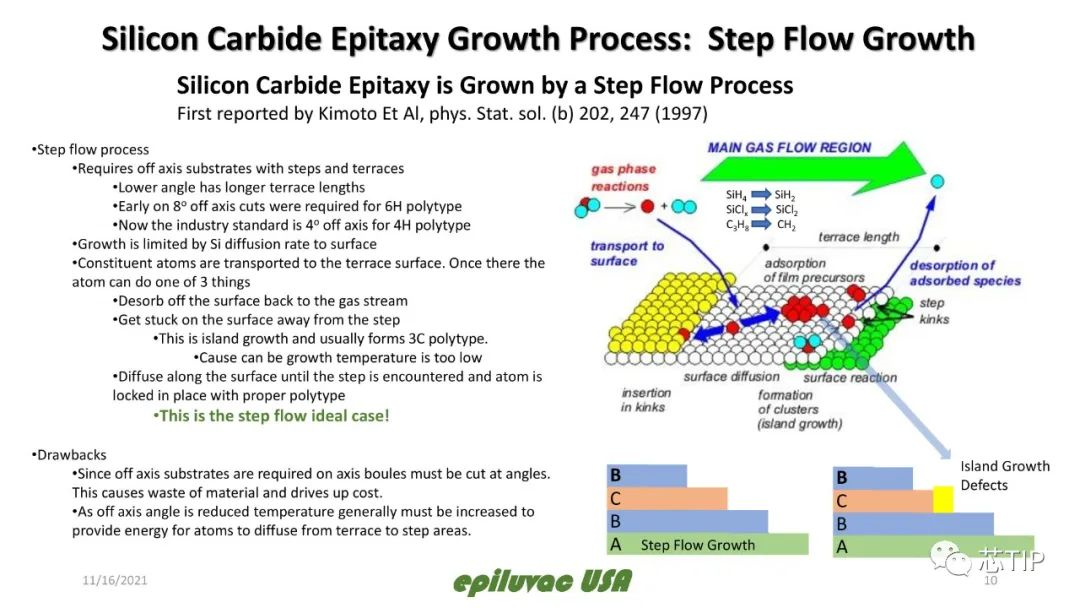
# SiC外延工艺:气体流速和比率
碳化硅外延生长率
• 生长速度与Si 流量成正比
碳化硅外延掺杂受C/Si比控制

# 近 30 年的 SiC 外延系统演变
Epigress热壁式SiC外延生长系统
• 单晶片 2” 直径
• 手动装载和卸载外延片
• 过程手动控制
• 基于硅烷 (SiH4) 的工艺 – 不含氯
• 增长率限制在 10 微米/小时左右
Aixtron 暖壁系统
• 多晶片 6” 直径 (8”)
• 自动加载和卸载外延片
• 配方控制过程
• 基于氯硅烷的工艺
• (TCS) 增长率通常为 30 微米/小时
• 主要用于>30um 的外延层
Epiluvac 集群式热壁系统
• 最大直径为 8 英寸的单晶片室
• 腔室可以组合在一个集群设备中,用于不同的掺杂层(n、p 型)
• 腔室之间的晶片转移发生在空闲温度和真空下。
• 外延片的自动加载锁定加载、预热、冷却和卸载
• 通过配方控制过程
• 基于氯硅烷 (TCS) 的工艺证明生长速率超过 100 um/hr

# SiC外延设备的配置

# 热壁 SiC 外延反应器热区 - 示意图
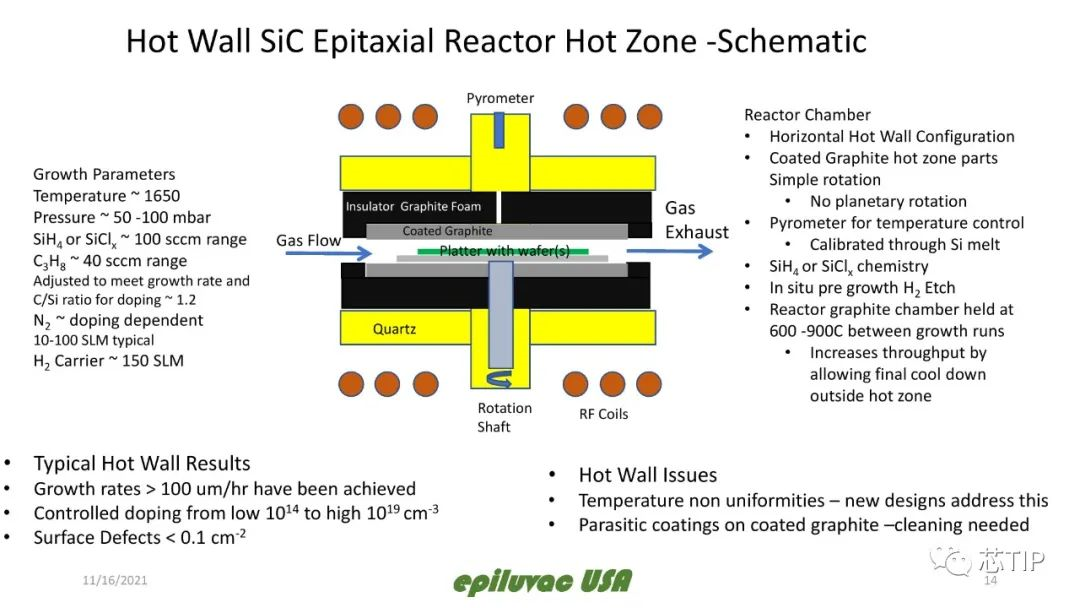
# 行星式 SiC 外延反应器组件
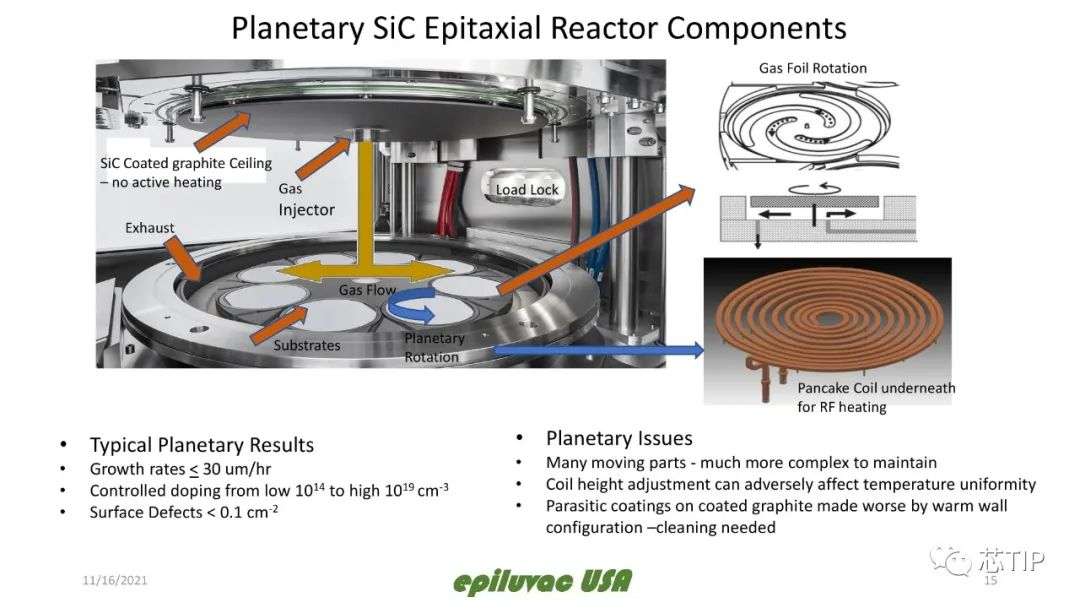
# 外延表征
在每个外延片上收集的数据
在选定的样品外延片上收集的数据

# 外延厚度表征

# 外延掺杂表征
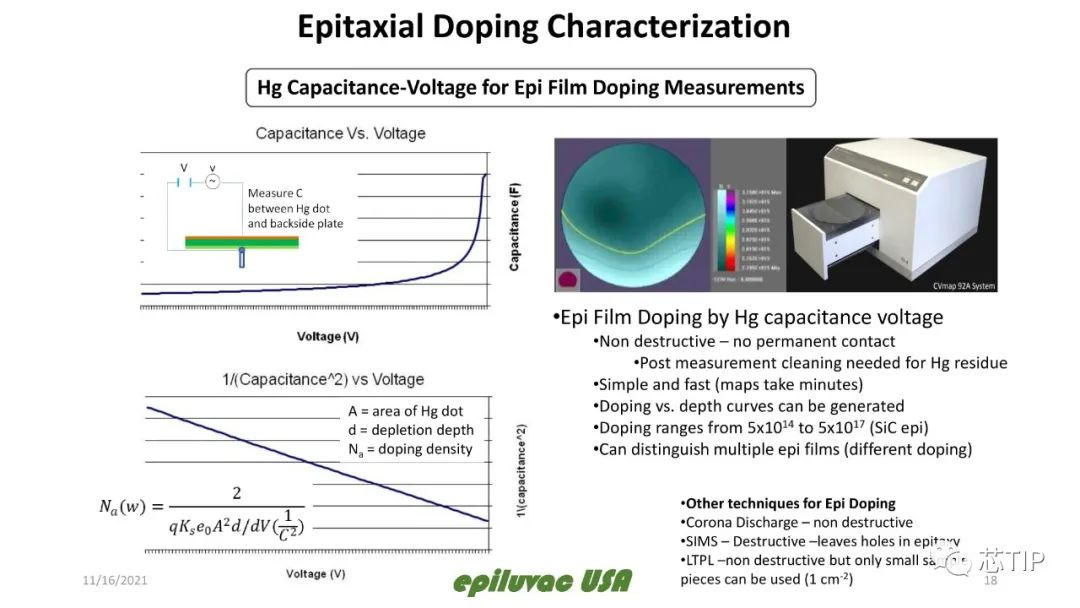
# 外延片形状表征
(通过电容探针技术测量外延片形状)

# SiC外延缺陷

# SiC外延表面缺陷

# 用 UVPL 检测碳化硅外延位错缺陷

# 总结
• 碳化硅在电力电子领域的发展迅速
• 为了向行业提供高质量的外延片,需要:
• 了解 SiC 外延生长过程至关重要
衬底
成长参数与机制
表征设备和技术
• SiC 外延设备——有多种选择(现在与未来)
• 外延片表征技术和商业要求
厚度和掺杂准确度和均匀度
缺陷类型和控制
特殊要求
声明:本文版权归原作者所有,转发仅为更大范围传播,若有异议请联系我们修改或删除:zhangkai@cgbtek.com

