芯片未来怎么发展?IMEC这样看
芯片未来怎么发展?IMEC这样看
未来几年将在工业中引入哪些逻辑 CMOS 缩放的新创新?
在imec看来,使用晶圆背面为设备供电是下一个主要的性能提升器。晶圆正面的传统金属层将用于路由信号,而晶圆背面的金属层将用于供电。将电源传输和信号路由分开可以降低电源中的压降(从而提高性能)并减少前端金属路由的拥塞。
英特尔也宣布,他们将在 2nm 节点上引入这种带有纳米片器件的器件。
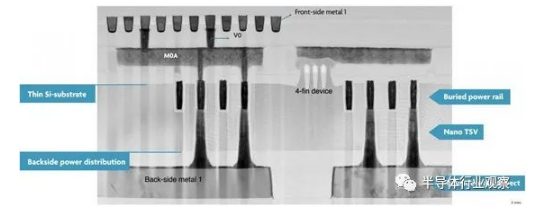
TEM 图像显示了连接到晶圆背面和正面的缩放 FinFET。
IMEC进一步指出,纳米片和forksheets之外的器件架构是complementary FETs (CFET),其中 N 和 P 器件使用复杂的集成相互堆叠。imec强调。未来还有几种潜在的 CFET 类型,但他们正处于探索的早期阶段。
在后端金属化中,IMEC表示,铜双镶嵌集成将让位于高纵横比金属蚀刻以形成低于 20nm 间距的图案线。而IMEC一直专注于将钌用于直接金属蚀刻。为了降低电阻,钌的纵横比将随着气隙的增加而增加,以减少电容的影响。这些更改将确保后端 RC(电阻-电容)扩展路线图在多个节点上继续进行。
IMEC方面认为,逻辑和内存组件的扩展变得越来越困难。即使由于集成复杂性导致成本继续增加,节点到节点的改进也在减少。在设计方面,有一种趋势是为每个功能(如神经处理、图形、视频等)创建更多特定领域的加速器,并且更加关注硬件-软件协同优化以在系统级别获得更多收益。
还有一个驱动力来确定特定技术以解决系统瓶颈,例如内存墙(如何以高带宽获取数据,以足够的速度和足够低的功率为逻辑内核供电),电源墙(如何有效地处理电力传输和散热)或数据通信瓶颈(如何确保有线、光子学和无线基础设施能够处理成倍增长的数据流量),而不是依赖现成的通用技术。
据IMEC所说,在 AMD 的 V-cache 技术等高性能计算空间中有一些示例,其中使用 3D 集成使额外的 SRAM 内存更接近 CPU。另一个例子是使用硅中介层桥接连接 Apple M1 Ultra 片上系统 (SoC) 中的两个 CPU 芯片。
随着光学 IO 系统中数据带宽的增加,行业还在大力推动利用不同的 3D 和 2.5D 技术共同封装电子和光子 IC,以减少寄生电阻。对于3D 和 2.5D 连接,根据连接密度、成本和复杂性,有多种选择。设备、计量和 EDA 基础设施也需要成熟,以推动标准化并降低成本以实现更广泛的采用。
IMEC表示,随着光学 IO 支持的数据速率增加,电子 IC 和光子 IC 使用共同封装的光学器件更紧密地集成以减少寄生效应。而他们正在开发新模块,以使共同封装的光学器件成为现实。
在主动式存储器计划中,IMEC不断提高 IGZO(铟镓锌氧化物)器件的器件性能和可靠性,这将在未来的规模化 DRAM 架构中发挥关键作用。在IMEC的存储计划中,他们将继续为存储应用推动传统的全方位门控3D NAND 闪存扩展路线图。
转载微信公众号:半导体行业观察
声明:本文版权归原作者所有,转发仅为更大范围传播,若有异议请联系我们修改或删除:zhangkai@cgbtek.com

