聚焦 | 克服那个碳化硅晶片抛光难题
聚焦 | 克服那个碳化硅晶片抛光难题
原创 微安 碳化硅芯观察 2022-03-03 20:02
小抛光,大难题
SiC作为新一代半导体材料的性能优势明显,但由于其属于典型的难加工材料,实现SiC晶圆的高质量与高效率加工成为了推动其产业化应用进程的关键。SiC晶圆的生产过程包括拉单晶、磨外圆、切片、磨削、研磨及抛光等诸多工艺环节。
其中,抛光作为SiC晶圆生产链的最后一环,其加工后的晶圆表面质量会直接影响所生产的半导体器件的性能。因此,抛光加工是SiC晶圆应用于芯片制造的非常关键的工艺步骤。然而SiC具有的极高硬度和很强的化学稳定性给SiC的无损高质量抛光带来了极大的挑战。
众所周知,碳化硅的莫氏硬度达到9.25-9.5,用传统的CMP抛光移除材料1-2μm深度,需要数十小时才能完成,不仅影响产能,也导致成本居高不下。据台湾工研院测算,碳化硅晶圆制造成本约占售价的一半,而硅晶圆只需26%。

碳化硅晶圆与硅晶圆成本构成对比
而传统的研磨(lapping)和轮磨(grinding),通常存在表面微细刮痕、降低元件效率、效率低和表面粗糙度不佳等缺点。如果SiC基片表面有残留的损伤层,将导致外延层原子排列无序,影响外延层的质量,进而影响最终器件的性能。因此,作为SiC半导体器件的基片,需要控制基片表面厚度变化小于1 μm、Si面的表面粗糙度(Ra)≤0.3 nm、C面Ra ≤0.5 nm,且保证加工表面低加工损伤和残余应力,同时还需要基片表面具有很好的几何完整性和性能完整性。
一般来说,SiC表面的损伤层可以通过四种方法去除:
机械抛光,简单但会残留划痕,适用于初抛;
化学机械抛光(Chemical Mechanical Polishing,CMP),引入化学腐蚀去除划痕,适用于精抛;
氢气刻蚀,设备复杂,常用于HTCVD过程;
等离子辅助抛光,设备复杂,不常用。
1.选择化学机械抛光
单纯的机械抛光会产生划痕,单纯的化学抛光产生非均匀腐蚀,综合为化学机械抛光则物美价廉。CMP的工作原理:旋转的晶片/晶圆以一定的压力压在旋转的抛光垫上做相对运动,借助抛光液中纳米磨料的机械研磨作用与各类化学试剂的化学作用的结合来实现平坦化要求。
这一过程中应用到的材料主要包括抛光液和抛光垫。抛光垫使用后会产生变形,表面变得光滑,孔隙减少和被堵塞,使抛光速率下降,必须进行修整来恢复其粗糙度,改善传输抛光液的能力,一般采用钻石修整器修整。
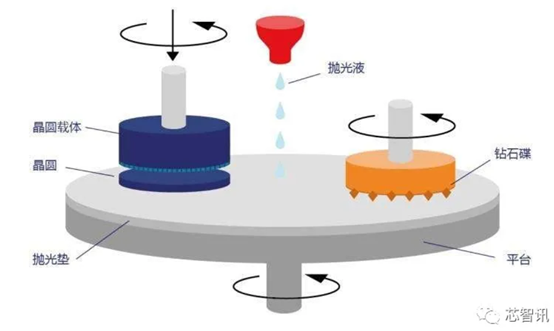

单纯的机械抛光会产生划痕,单纯的化学抛光产生非均匀腐蚀,具体如下所示:
第一,直接使用SiO2机械抛光,表面质量通过精度300nm的Kla Tencor-10的Candela和精度0.01nm的本原公司CSPM4000型原子力显微镜(AFM)测量,可测出划痕深度为9.78nm。
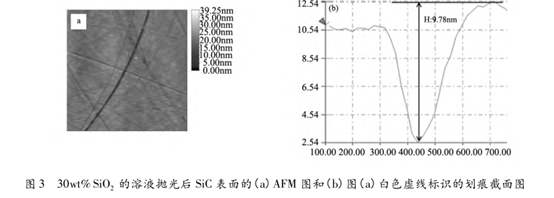
表面氧元素含量、穿透深度通过K-Alpha型X射线光电子能谱(XPS)仪分析:标准样为以He+溅射标准SiO2样品,溅射速率为25nm/min;试样为以He+溅射SiC样品。SiC硬度大于SiO2,所以溅射速率小于25nm/min。溅射0.25min后,氧元素信号为零,所以穿透深度小于25nm/min*0.25min=6.25nm。穿透深度小于划痕深度,说明划痕是机械作用产生的,而不是氧化作用产生的。

第二,同样的,如果直接使用双氧水抛光,反而会新增划痕。AFM图如下。这是因为化学腐蚀是具有各向异性的,对于表面能大的会加速腐蚀。
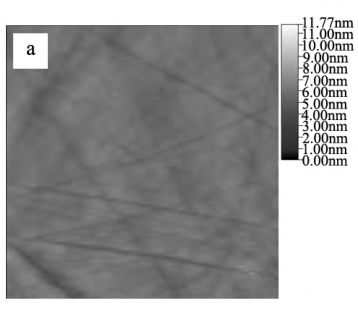
如果仅仅使用双氧水浸泡,那缺陷和划痕反而会被扩大。浸泡后,晶片表面粗糙度从0.06nm增大为0.14nm。AFM图如下,其中右上角为浸泡前:
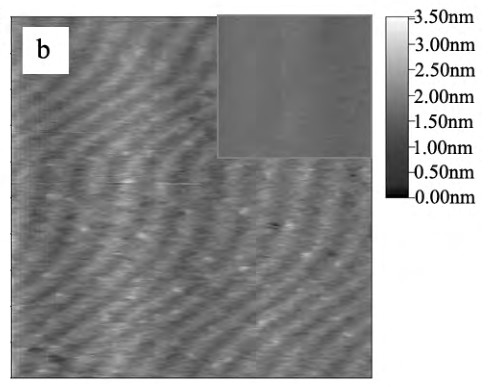
2. 典型的化学机械抛光过程
知道需要化学+机械来抛光后,典型的化学机械抛光过程如下:
第一步,机械抛光。
用0.5um直径的金刚石抛光液,抛光表面粗糙度至0.7nm。
第二步,化学机械抛光。
抛光机:AP-810型单面抛光机;
抛光压力200g/cm2;
大盘转速50r/min;
陶瓷盘转速38r/min;
抛光液组成:以SiO2(30wt%、pH=10.15)为基础,加入0-70wt%的双氧水(30wt%、纯优级),最后用KOH(5wt%)、HNO3(1wt%)调节pH=8.5;
抛光液流量3L/min,循环使用。
结果如下:
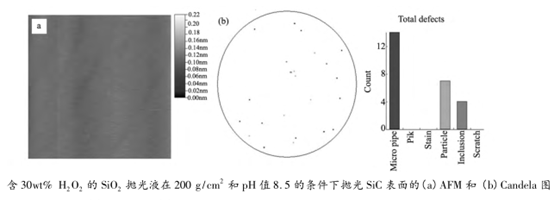
事实上,各种参数是可调的,要针对晶片和机子选择合适的条件:
可选机械抛光液为:SiO2、Al2O3、二氧化铈;
可选化学抛光液为:高锰酸钾、双氧水、Pt催化剂、Fe催化剂;
可选抛光垫:尼龙、聚氨酯;
酸碱性:KOH、HNO3;
机械作用:压力、转速、位置、时间、温度。
目前,业界提出了改良式的化学机械抛光制程,比如混合了胶态二氧化硅和奈米钻石磨料,用二氧化钛(TiO2)和氧化铈(CeO2)做为研磨液,利用水气大气电浆进行碳化硅表面氧化。
然而,这些加工制程的材料移除率(MRR)都相当低,传统材料移除率< 0.2 μm/h,相比之下,4英寸碳化硅晶圆的抛光制程需耗时≧10小时,因此产能没法提升,成本下不来。为了解决效率问题,需要导入复合式加工概念,比如导入化学、振动、电化学改质或激光加工等复合机制。
新的解决方案
去年,台湾工研院有一项新发明——“超音波&电浆辅助加工技术”,它可以将4英寸碳化硅晶圆的材料移除效率提升36倍,而且加工后的表面粗度Ra仅为1-2nm,这大幅降低了薄化设备的成本。同时,碳化硅的抛光速率也提升了5倍以上,能够将加工成本降低50%左右。
整个设备构成是这样的

据介绍,超音波辅助轮磨主要针对晶圆立式高耗数轮磨制程(>8000号),通过导入超音波振动机制,来降低砂轮填塞,并增进砂轮自锐功效。
测试对比发现,无超音波辅助进给速率为2um/min,移除量约2um;而超音波辅助进给提升至12um/min,移除量约17um,材料移除效率提升约36倍。
而且,加工完后的芯片表面粗度Ra达1-2nm,传统粗抛光表面Ra约10nm,大幅降低细抛制程的加工负荷,每台薄化设备成本也将大幅下降。

超声波辅助轮磨加工平台
通常,碳化硅晶圆整个抛光过程需花费10小时左右。行业是通过添加KMnO7、KNO3等添加剂来提升抛光速度,但这对人体和环境有害,也可能造成机台损伤。
台湾工研院的方法是——在传统CMP中搭配大面积大气电浆系统。电浆辅助加工是一种电浆氧化、蚀刻的工艺,可以促使SiC晶圆表面软化或形成气态物种脱离表面,从而提高抛光加工制程的移除率。
测试结果发现,相比传统机械抛光,这种方式将抛光速率提升了5倍以上,有望降低30-50%加工成本。
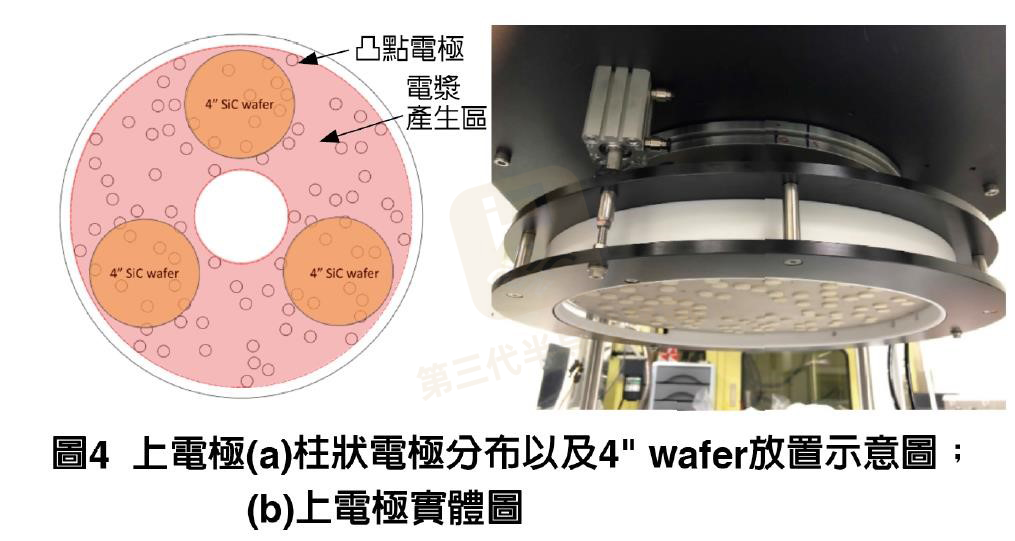
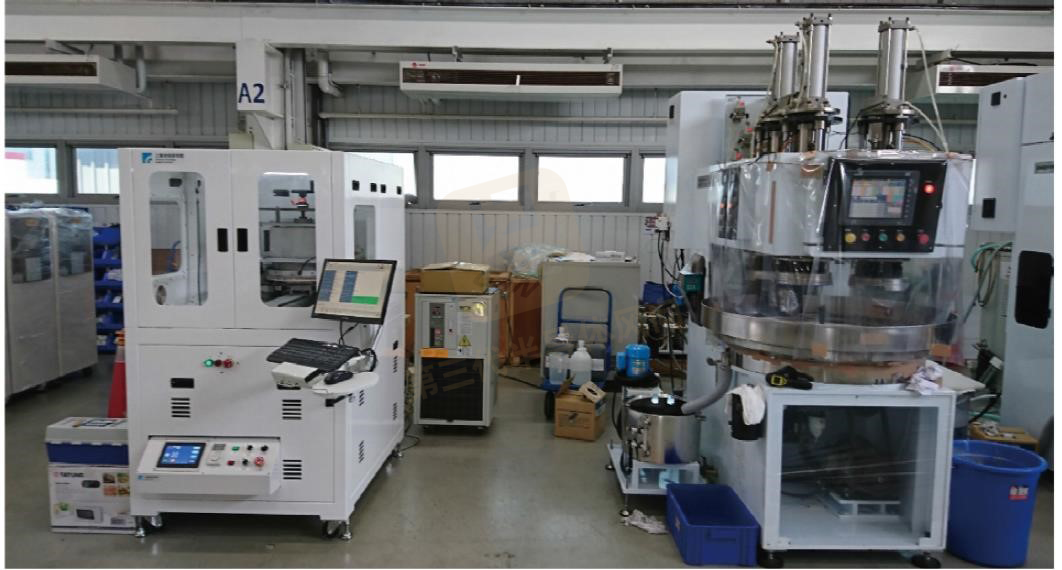
测试场地:电浆机台(左)、市售抛光机(右)
也是在去年,南方科技大学发表了一篇论文,介绍了最近的研究进展:借助等离子体进行表面改性,结合软磨粒抛光技术实现SiC材料高效去除的等离子体辅助抛光(plasma-assisted polishing,PAP)技术。
PAP技术由日本大阪大学的Yamamura于2010年首次提出。机械研磨能够实现SiC的高效加工,但是由于其机械摩擦的去除本质,不可避免地会在加工后表面产生划痕及亚表面损伤。
而等离子体化学蒸发加工技术(plasma chemical vaporization machining,PCVM)的去除原理为化学反应,能够实现无损伤加工,但是其材料去除效率不高,且去除过程表现出各向同性,这导致该技术在原子尺度的平整能力较弱。PAP技术将两者的优势相结合,极大地提高了SiC的加工效率,并且不会产生亚表面损伤。
此外,PAP技术与PCVM技术的去除方式截然不同,PAP技术中等离子体的作用仅是进行表面改性,而材料去除过程依赖于软磨料的摩擦作用,因此PAP技术在原子尺度具有很好的平整能力,能够获得较高的表面质量。
PAP技术的原理如图1所示,首先用等离子体辐照SiC表面;等离子体中的自由基具有强氧化性,与SiC表面原子发生化学反应,形成硬度较低的改性层;然后用软磨料抛光去除该改性层。随着等离子体化学改性和软磨料抛光去除的交替进行,粗糙表面逐渐变平整,最终能够获得一个无损伤的原子级平坦表面。
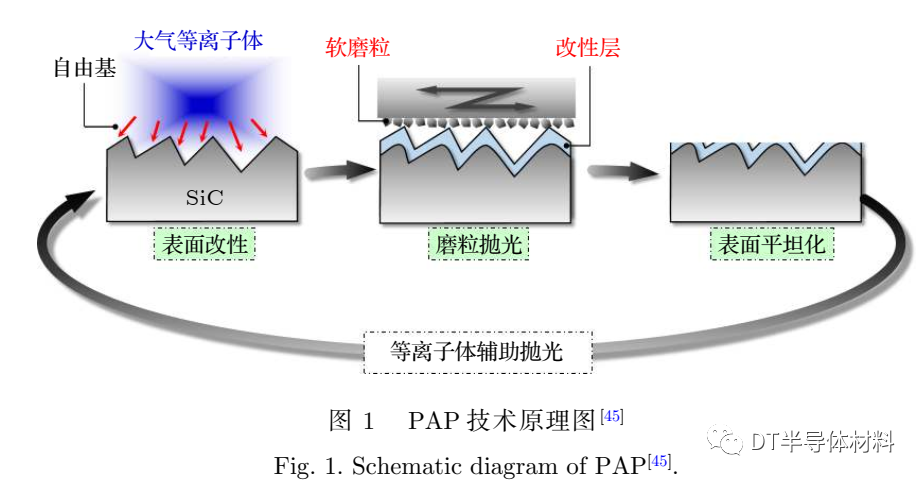
图2(a)为PAP加工设备的示意图,该设备由独立的等离子体发生单元和材料去除单元组成[40]。等离子体由射频电源产生,加工过程中以惰性气体作为载气,水蒸气或O2等能够产生强氧化性自由基团的气体作为反应气体。图2(b)展示了实物装置[45],该装置所用的射频电源频率为13.56MHz,反应气体为水蒸气,基于此产生了直径约为8mm的等离子体。
装置具体工作流程为:待加工样品固定于转台之后,依次进行等离子辐照表面改性和软磨料抛光。其中等离子体辐照区域和软磨料抛光区域与转盘中心的距离相同,即图2(a)中r1=r2,从而保证了软磨料抛光区域恰为改性区域。因此使用该装置获得的抛光区域是一个宽度约为8mm的环形区域。
图2(c)展示了实验中所用的抛光垫的截面图及扫描电子显微镜(scanning electron microscope,SEM)图[45],实验中采用固结磨料抛光垫,该抛光垫可以避免由于抛光粉的团聚或分布不均匀等原因造成的表面划痕或抛光不均匀等现象的发生,并且不断更新的磨粒可以保证抛光效率稳定,同时不会有水解层产生。
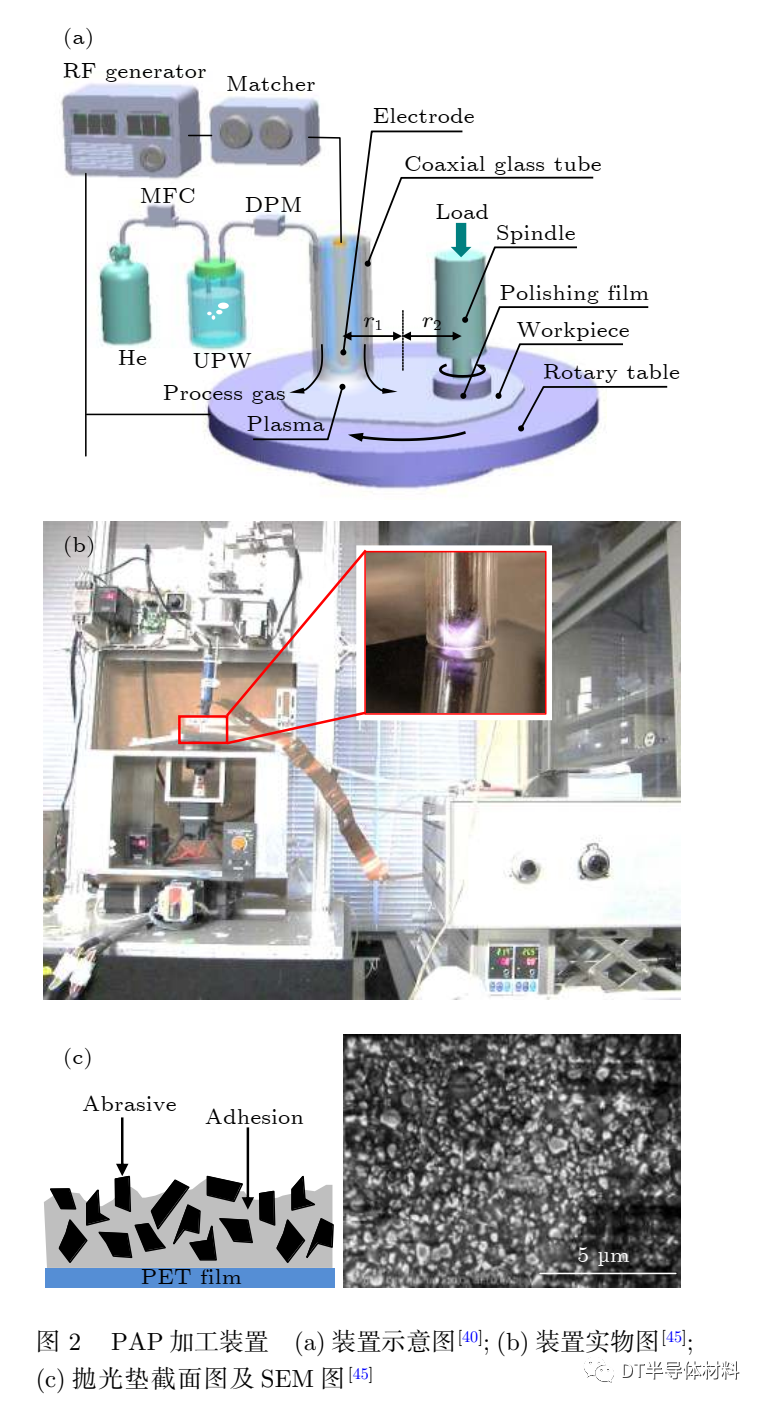
为了对等离子体的改性效果及改性效率等信息进行更为深入的分析,研究采用横截面透射电子显微镜(cross-sectional transmission electron microscope,XTEM)对经等离子体改性1h(反应气体为水蒸气)的SiC样品进行了观察,如图5所示。
结果表明,改性层厚度约为80nm,且结合X射线光电子能谱仪(X-ray photo electron spectroscopy,XPS)测量结果,可知该改性层的组分为硬度远小于SiC的SiO2。此外,改性层的上表面存在一定起伏,但SiO2/SiC界面呈原子级平坦。
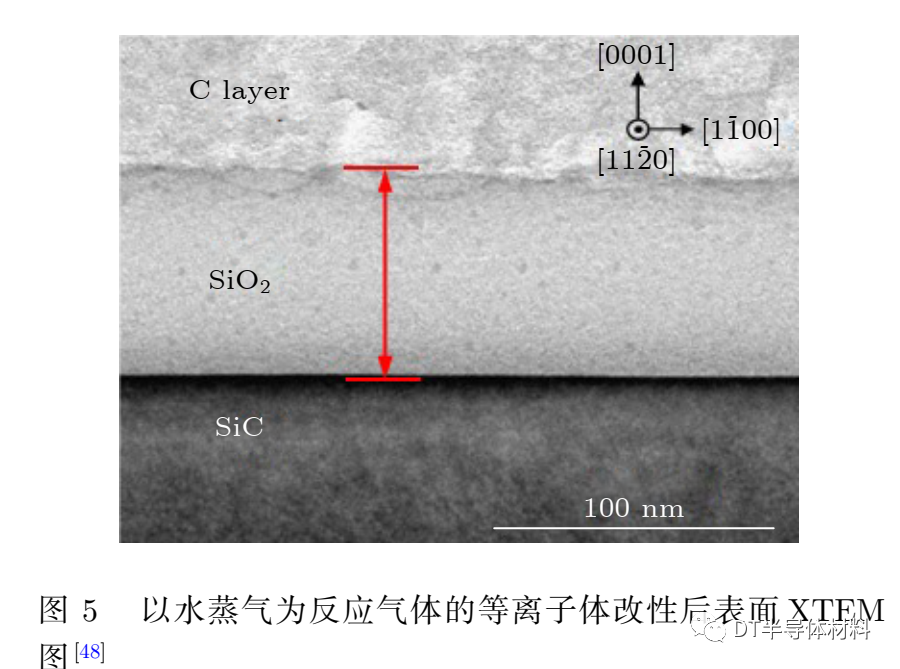
PAP技术是通过将表面材料氧化为较软的改性层而实现高效加工的。因此,有必要测量等离子体改性前后的表面硬度变化。纳米压痕仪能够较为准确地测量表面纳米硬度,实验中采用的表面改性条件及纳米硬度测试条件详见文献。
图6展示了采用纳米压痕法测得的改性前后SiC样品的表面硬度。可以发现,等离子体改性后的SiC表面硬度显著降低,从改性前的(37.4±0.5)GPa降低为(4.5±0.8)GPa,改性后的表面硬度和文献中报道的使用纳米压痕方法测得的SiO2膜的硬度相近,这也从侧面验证了改性层的成分。

综合以上实验结果可知,当反应气体为水蒸气或O2时,等离子体都能够实现SiC表面改性,但是由于水蒸气电离产生的OH自由基较O2电离产生的O自由基具有更强的氧化性,因此以水蒸气作为反应气体的等离子体的改性效率更高。
此时,等离子体辐照能够有效地将SiC表面改性为硬度较小的SiO2,改性后的表面硬度降低为改性前的0.12倍。
写在最后:
碳化硅成本一直高居不下的主要原因主要是没有突破晶片的生产制造环节壁垒,长晶和衬底晶圆制造是“卡脖子”核心技术,是整个产业链的共性技术问题,也是国产器件良率迟迟不能提高的主要原因。
今天我们从小小的抛光环节看产业,需要有共性的平台去解决材料、设备、辅助工具链开发的问题,需要有设备企业持续投入研发、制造企业的不断迭代,芯片产业链就是这样需要专业分工,齐头并进的。从小小抛光看产业,与君共勉!
声明:本文版权归原作者所有,转发仅为更大范围传播,若有异议请联系我们修改或删除:zhangkai@cgbtek.com

